6月21日,在由上海有色网信息科技股份有限公司(SMM)、湖南宏旺新材料科技有限公司、娄星区人民政府、国家级娄底经济技术开发区联合主办的2025SMM(第四届)电驱动系统大会暨驱动电机产业论坛——汽车电驱动系统论坛上,巨一动力系统有限公司驱动模块专家钟敬稳对“电控逆变砖技术发展规划”这一主题进行了分享。

一、逆变砖规划
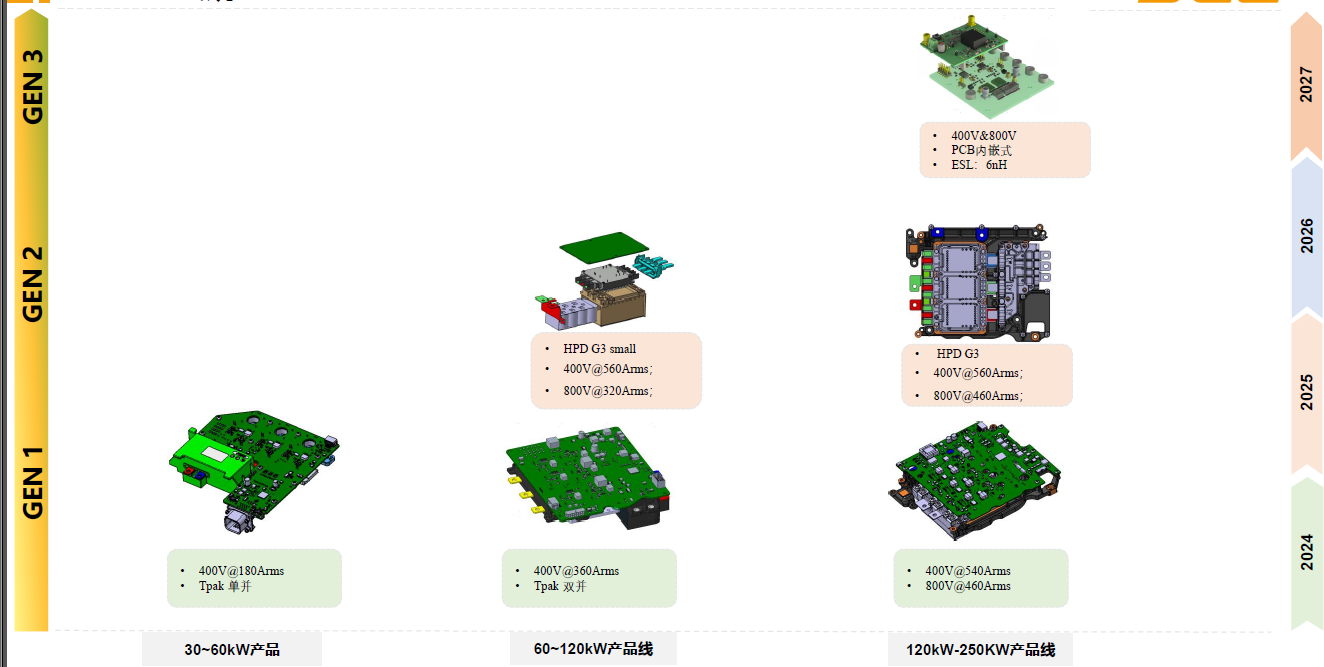
二、逆变砖Gen1展示
逆变砖Gen1展示(小功率段TPAK)
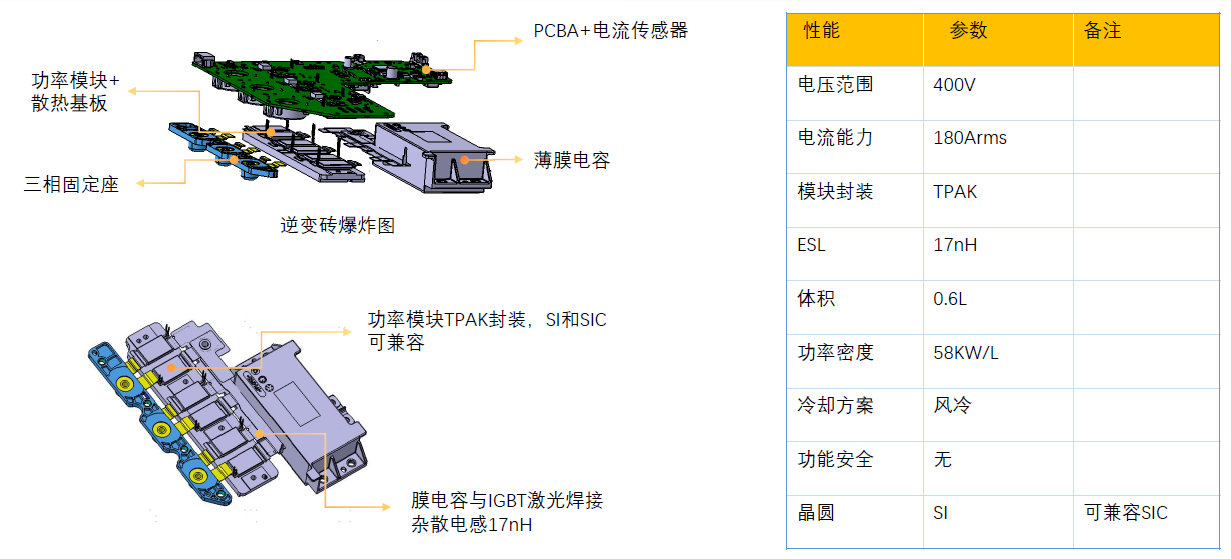
其还对逆变砖Gen1展示(中功率段TPAK并联)、逆变砖Gen1展示(大功率段HPD)、逆变砖Gen1展示(双电控)等内容进行了分析。
三、逆变砖Gen2展示
逆变砖-Gen2需求分析

Gen2逆变砖性能提升需求:
•低杂散电感,降低开关损耗,适配SIC应用;
•平台化设计,高兼容性(电压平台,SIC&IGBT);
•提高结温监测的准确性及有效性;
•快速的过流保护,适应SIC应用;
•高效散热,高功率密度
•功率模块结温耐温提升;
•成本优化。
逆变砖-Gen2
中功率平台逆变砖(<150kW):
•兼容400V、800V平台;
•兼容IGBT与SIC功率模块。
高功率平台逆变砖(<250kW)
•兼容400V、800V平台;
•兼容IGBT与SIC功率模块。
逆变砖Gen2-低杂散设计和电容一体灌封
低杂散设计:DC-Link电容优化母排及芯子设计,杂散电感控制<2nH;功率模块端子连接采用激光焊接工艺,整体杂散电感控制<5nH。
电容一体灌封:DC-Link电容与壳体水道一体灌封,可有效降低成本,减小体积,提升芯子散热能力。
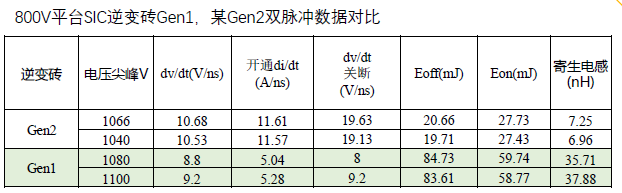
•Gen2逆变砖系统杂散可降低至8nH,较Gen1降低75%;在电压尖峰相同的情况下,开关损耗降低70%,可以极大的提升SIC模块的效率及输出能力。
逆变砖Gen2-功率模块
集成无磁芯电流检测:三相电流采样使用无磁芯检测方案,省去传统的磁芯,可有效降低传感器成本;磁芯的减小及三相铜排采用激光焊接工艺可有效缩短三相端尺寸。
兼容性:IGBT与SIC封装兼容;800V与400V平台封装兼容。
高功率平台-HPD G3:470V@≥560Arms;900V@≥460Arms;Tjmax185°C@SIC。
中功率平台-HPD SMALL:470V@≥560Arms;900V@≥320Arms;Tjmax 185°C@SIC。
支持on chip温度检测:支持on chip温度检测能力,可以实现快速、直接有效的结温监测并执行保护;
支持on chip过流检测:SIC模块的短路耐受能力较弱,支持on chip过流检测可快速执行过流及短路工况保护。
逆变砖Gen3展示(PCB 嵌埋式封装技术)
技术方案介绍:
嵌埋式模组杂感低约为3nH,嵌埋系统杂感约为6-8nH;HPD封装杂感约为8-10nH;HPD系统杂感约为25nH-30nH;
动态损耗相比HPD系统降低约50%,相同芯片面积出流提升20%;
模块总成本:嵌埋式封装可降低约10-20%,主要贡献来自芯片面积节省。(前提:PCB嵌埋工艺良率水平提升,达到常规PCB量产良率水平)
电控系统成本:功率密度提高、集成化程度提高;电控系统成本有机会进一步降低。
逆变砖Gen3展示(PCB 嵌埋式封装技术)